电子灌胶封装
使用聚氨酯(PU)、硅胶或环氧树脂进行电子灌封具有多重优势
电子灌胶封装
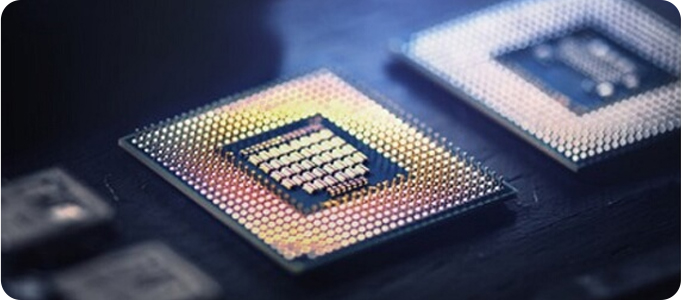


MOLDEX3D 解决方案
製程設計確認並改善處理條件
流體、溫度、相場和熟化程度的模擬
考慮表面張力、毛細力和重力的影響
優化澆口和流道設計
氣泡包封預測

後熟化翹曲模擬
透过数值模拟观察相变化过程
完整考虑应力释放及化学收缩
透过温度、熟化率及应力分布模拟,预测后熟化过程中的变形
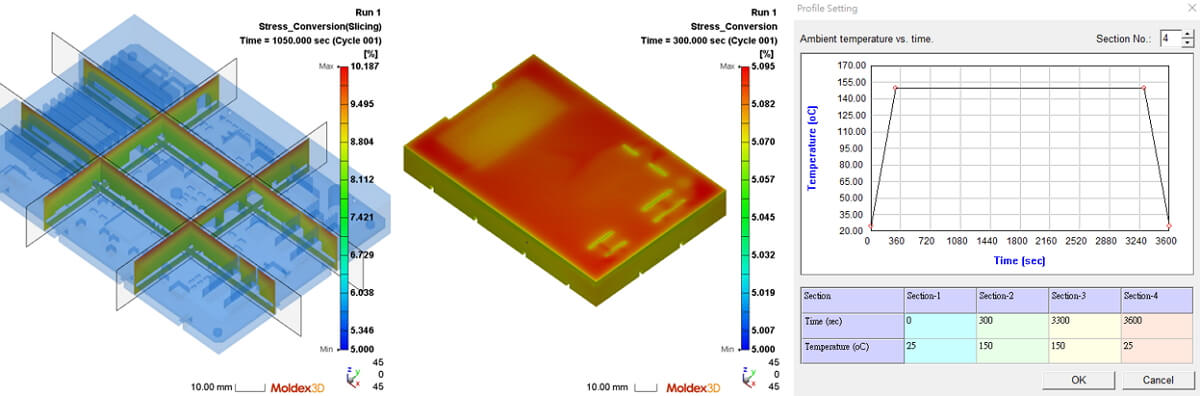
先進材料特性測量及模擬
测量熟化反应动力学、黏度及黏弹性特性,以进行流动模拟
量测黏弹性应力释放、化学收缩及热膨胀效应,应用于翘曲预测
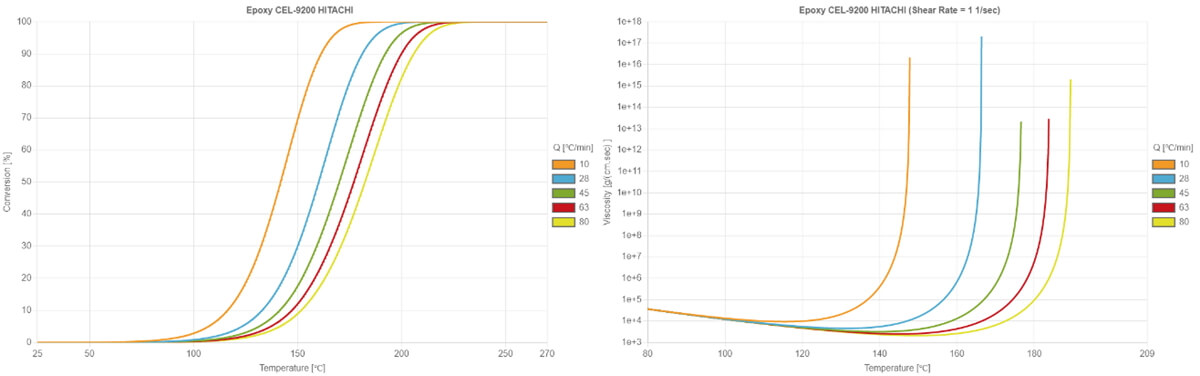
应用领域
電子灌封 PCB 元件
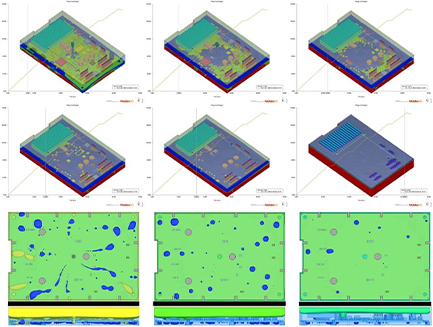
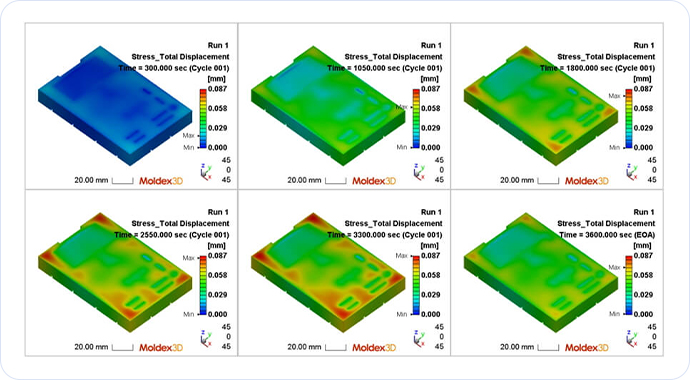
馬達轉子線圈的電子灌封
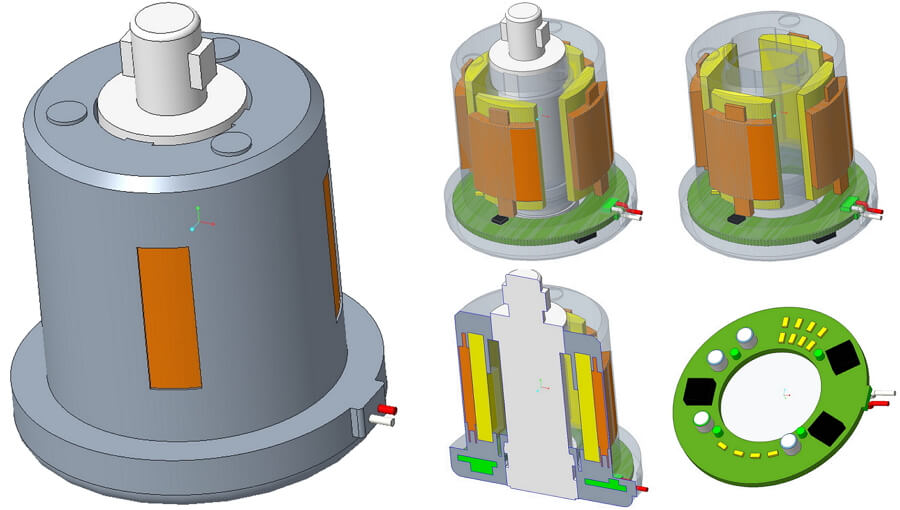
Moldex3D 可预测灌封过程中气泡行程和包封位置,有助选择最适合的材料和最佳的制程参数及制程优化。灌封后的后熟化分析,可深入了解固化时间、化学收缩、及因黏弹性效应引起的应力释放。

行動電子產品的封裝填充



